- ASML lidera en solitario la litografía EUV gracias a un ecosistema único de socios como TRUMPF, Cymer y Zeiss.
- El láser de CO2 de TRUMPF genera plasma a partir de gotas de estaño para producir la luz EUV de 13,5 nm.
- El salto de 600 a 1.000 W en la fuente de luz EUV permite aumentar hasta un 50 % las obleas procesadas por hora.
- La nueva plataforma High-NA EXE prepara nodos de 2 nm y menores, manteniendo viva la Ley de Moore.
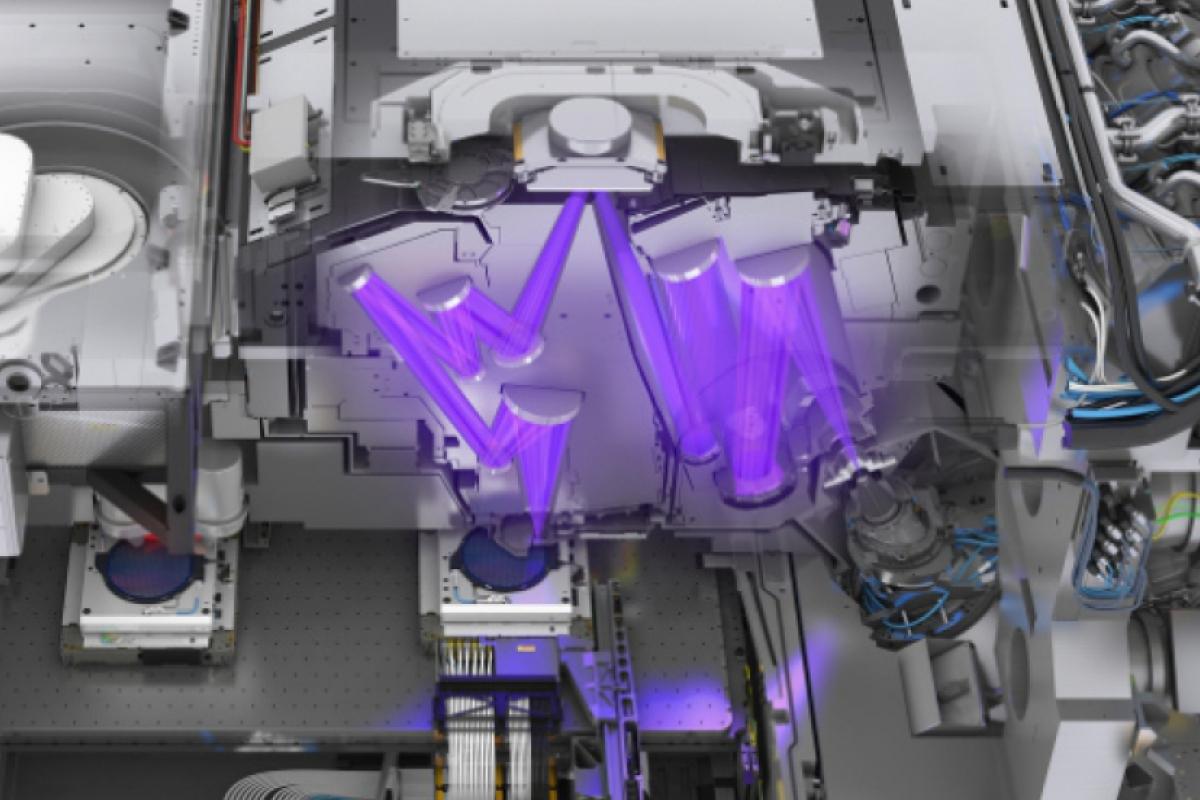
La industria de los semiconductores vive una auténtica revolución silenciosa, y en el centro de todo está ASML con sus láseres de CO2 y la litografía EUV. Sin estas máquinas, compañías como TSMC, Intel, Samsung o SK Hynix sencillamente no podrían fabricar los chips más avanzados que mueven móviles, centros de datos, inteligencia artificial o coches autónomos.
Lo llamativo es que buena parte de esta revolución depende de algo tan “poco glamuroso” como un gigantesco láser de CO2 que convierte diminutas gotas de estaño en plasma. A partir de ahí se genera una luz ultravioleta extrema (EUV) de 13,5 nm que permite “dibujar” circuitos con detalles de pocos nanómetros sobre obleas de silicio. Vamos a desgranar con calma cómo funciona todo este tinglado, qué papel juegan ASML, TRUMPF, Cymer y Zeiss, y por qué esto se ha convertido en un monopolio prácticamente intocable.
ASML y el monopolio de la litografía EUV
ASML, con sede en Países Bajos, es hoy el único fabricante del mundo capaz de suministrar equipos de litografía EUV para producir chips de vanguardia. Sus sistemas están instalados en las fábricas de TSMC, Intel, Samsung y otros gigantes, y son imprescindibles para nodos como 5 nm, 3 nm, 2 nm y los que vendrán por debajo.
El dominio de ASML no es casualidad: la empresa ha sabido agrupar a un ecosistema único de socios tecnológicos que incluyen a Zeiss (óptica alemana de altísima precisión), Cymer (fuentes de luz UV profunda y extrema) y TRUMPF (láseres de CO2 de enorme potencia), entre otros proveedores estratégicos.
Las compañías japonesas Canon y Nikon intentaron competir en su día en litografía EUV, pero el nivel de inversión y complejidad técnica era tan brutal que abandonaron la carrera. Eso dejó a ASML vía libre para consolidar una posición de monopolio en el segmento más avanzado de la fotolitografía.
Este monopolio, al que algunos analistas se refieren como “invisible” pero totalmente determinante, hace que Europa tenga una voz muy relevante en la cadena global de valor de los semiconductores, pese a que la mayoría de fábricas punteras estén en Asia y Estados Unidos.
La estrategia de ASML ha sido atar a sus proveedores clave con inversiones, compras y participación accionarial, además de centros de I+D compartidos. Por eso, muchos de los componentes críticos de sus máquinas sólo pueden fabricarlos un número muy pequeño de empresas, lo que refuerza aún más su posición exclusiva en EUV.
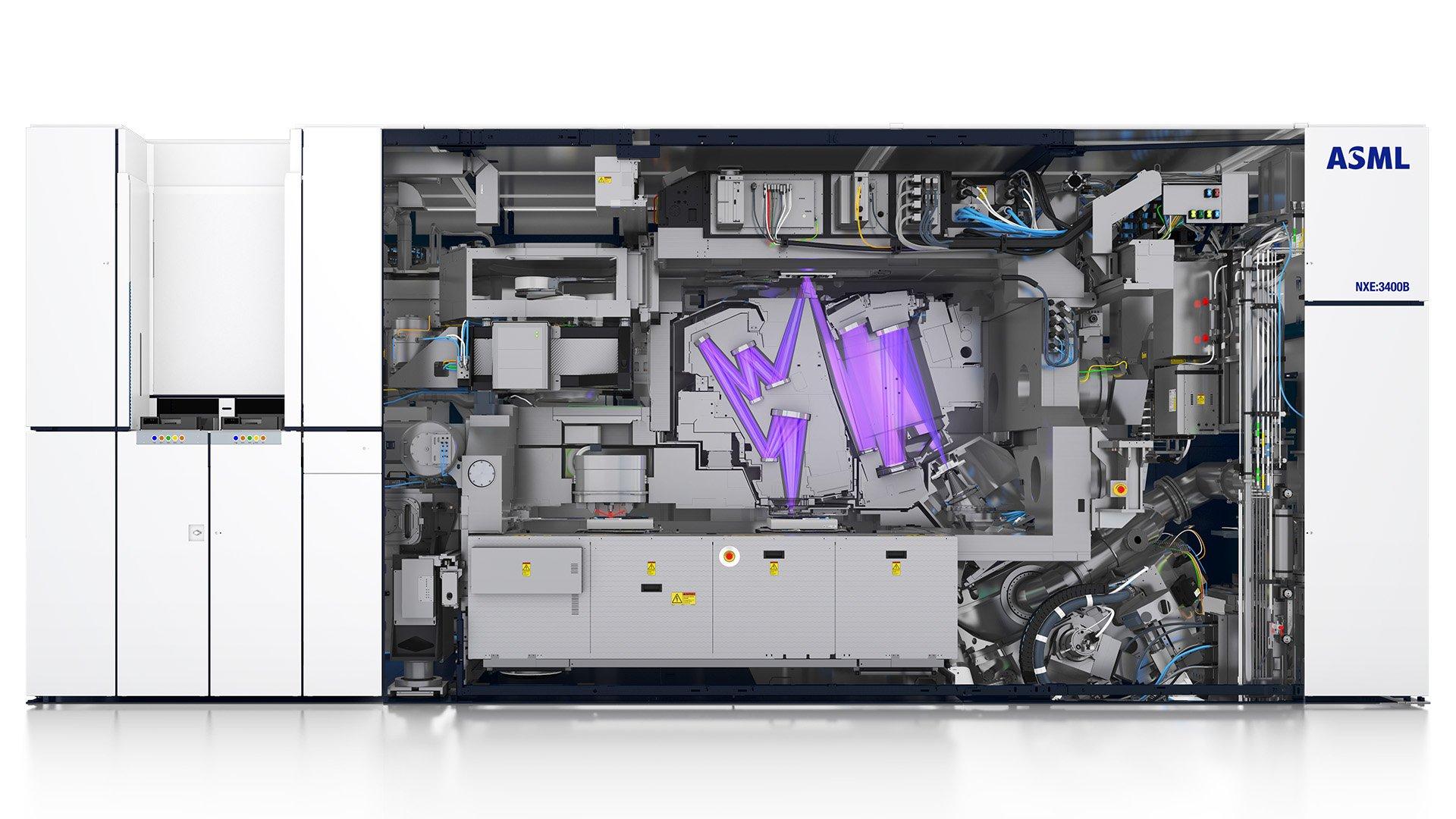
Cómo funciona la litografía EUV de ASML
Para entender el papel del láser de CO2 hay que tener claro primero el principio básico de la litografía EUV. A grandes rasgos, el sistema se apoya en tres bloques fundamentales: la fuente de luz ultravioleta extrema, la óptica (espejos y proyección) y el sistema de mesa que posiciona obleas y máscaras.
El proceso comienza generando radiación EUV con una longitud de onda de 13,5 nanómetros. Esta luz tan energética se utiliza para transferir el patrón geométrico de una máscara (que contiene el diseño del chip) a una oblea de silicio recubierta con un material fotosensible.
La máscara actúa como una plantilla que bloquea o deja pasar la luz en zonas muy concretas. Allí donde la luz llega al fotoresist, la química cambia. Después se aplican procesos de revelado, grabado y deposición para ir construyendo capa a capa los transistores y las interconexiones del circuito integrado.
La analogía con la fotografía química clásica es bastante clara: se expone, se revela y se “fija” el patrón, pero aquí hablamos de resoluciones del orden de pocos nanómetros, algo que hasta hace poco parecía ciencia ficción y hoy permite chips comerciales de 3 nm y, en breve, de 2 nm.
La luz EUV se sitúa en la parte más energética de la banda ultravioleta del espectro electromagnético, abarcando aproximadamente desde 10 hasta 100 nm de longitud de onda. Manipularla es un reto descomunal: es tan energética que altera los materiales con los que entra en contacto dentro de la máquina, y además debe viajar en un entorno de vacío casi perfecto.
Por eso, todo el trayecto de la luz desde la fuente hasta la oblea se realiza en cámaras de vacío extremadamente limpias, sin polvo ni gases que puedan absorber la radiación. Aquí es donde entra en juego la óptica de Zeiss, con espejos multicapa de precisión nanométrica diseñados para reflejar y moldear la luz EUV.
El salto de 600 a 1.000 W: más wafers y más chips por hora
Hasta hace poco, las máquinas EUV de ASML utilizaban fuentes de luz con una potencia en torno a 600 W. Esa cifra ya era impresionante, pero la compañía neerlandesa ha conseguido elevarla hasta los 1.000 W, y tiene la vista puesta incluso en 1.500 y 2.000 W a futuro.
Este aumento de potencia no es un simple detalle técnico; tiene un impacto directo en la productividad. Con 600 W, los sistemas EUV de ASML alcanzaban unas 220 obleas procesadas por hora en las fábricas punteras. Con 1.000 W, ASML anticipa poder llegar a unas 330 obleas por hora.
Traducido a términos de negocio, eso supone un incremento de alrededor del 50 % en la producción de chips por máquina, siempre que el resto del flujo de fabricación acompañe. Es decir, más chips funcionales por oblea y una reducción significativa del coste por chip.
Además de la pura velocidad, este salto de potencia también influye en el “yield” o rendimiento de fabricación, que es el porcentaje de circuitos que salen buenos en cada oblea. Una iluminación más potente y estable ayuda a minimizar defectos y a mantener más controlado el proceso.
ASML ya ha indicado que sus fuentes de luz de 1.000 W deberían estar disponibles alrededor de 2030 en sus máquinas de muy alta productividad, mientras sigue trabajando en una hoja de ruta que lleve esa cifra a 1.500 W y más adelante a 2.000 W, lo que sería otro cambio de juego para los fabricantes.
De gotas de estaño a plasma: el papel del láser de CO2
El corazón del sistema EUV es la fuente de luz, y ahí es donde el láser de CO2 de muy alta potencia se vuelve imprescindible. El método que se utiliza se conoce como LPP (Laser Produced Plasma, o plasma generado por láser).
En la práctica, el sistema inyecta al vacío microscópicas gotas de estaño (Sn) a una frecuencia brutal. Esas gotas viajan en una trayectoria cuidadosamente calculada hasta el punto en el que serán “bombardeadas” por el láser de CO2.
Un láser de CO2 de unos 30 kW de potencia, suministrado por TRUMPF, impacta sobre cada gota y la vaporiza, transformándola en un plasma extremadamente caliente. En ese estado, las temperaturas llegan a superar incluso las de la superficie del Sol.
Ese plasma emite radiación en la banda de los 13,5 nm, que es justo lo que necesitamos como luz EUV utilizable para la litografía. Después, un sofisticado sistema óptico recoge y condensa esa luz, la filtra y la envía hacia los espejos de Zeiss que la dirigirán a la máscara y, finalmente, a la oblea de silicio.
Lo verdaderamente impresionante es la escala del sistema: el láser de CO2 de TRUMPF que se emplea en estas fuentes de luz EUV es único en el mundo, con unos 457.329 componentes, más de 7.300 metros de cableado interno y un peso en torno a 17 toneladas. Todo ello empaquetado para funcionar de forma estable en un entorno industrial 24/7.
De un láser a dos: cómo se llega a 1.000 W de potencia EUV
Para pasar de 600 W a 1.000 W de potencia EUV real, ASML no se ha limitado a “apretar más” el láser, sino que ha refinado profundamente la física interna de la fuente de luz. Uno de los cambios más relevantes es el uso de doble impacto láser sobre cada gota de estaño.
El sistema ha pasado a duplicar el número de microgotas de estaño hasta las 100.000 por segundo. Cada gota es interceptada con una precisión increíble en el momento exacto por los pulsos de láser de CO2.
En lugar de utilizar una sola ráfaga de láser, como se hacía en las generaciones anteriores, los nuevos sistemas emplean dos impactos láser de CO2 secuenciales. El primero se encarga de preformar la gota (por ejemplo, aplanarla o darle una geometría más adecuada), y el segundo la vaporiza de manera óptima para maximizar la emisión EUV.
Esta estrategia de doble láser permite extraer más luz EUV por cada gota de estaño, además de mejorar la estabilidad y la homogeneidad del plasma. El resultado es una fuente de luz más intensa, con menor fluctuación y por tanto más aprovechable para litografía de alta productividad.
A partir de aquí, ASML ha definido una hoja de ruta que apunta a superar los 1.500 W y luego acercarse a los 2.000 W de potencia EUV. Cada escalón implica nuevos desafíos térmicos, ópticos y de estabilidad, pero también abre la puerta a mayor rendimiento de las fábricas y a seguir estirando la famosa Ley de Moore unos cuantos años más.

TRUMPF y el láser de CO2: un componente único en el mundo
Si ASML pone el sistema completo y Zeiss la óptica, TRUMPF es quien suministra el láser de CO2 que hace posible la fuente EUV. Este láser no es un producto genérico, sino un sistema desarrollado específicamente para las exigencias de la litografía extrema.
TRUMPF ha creado un amplificador láser de CO2 de alto rendimiento capaz de operar alrededor de 30 kW, con una estabilidad y una calidad de haz que permiten focalizar la energía en un punto minúsculo donde se encuentra la gota de estaño.
La empresa alemana ha trabajado en estrecha colaboración con ASML y con Zeiss para alinear las necesidades de la fuente de luz con las capacidades del láser y las limitaciones de los espejos. El resultado es un sistema capaz de procesar más de 100 obleas por hora en configuraciones de alto rendimiento.
El CO2 Drive Laser de TRUMPF está formado, como se comentaba, por centenares de miles de piezas perfectamente orquestadas, kilómetros de cableado interno y un conjunto de módulos de potencia, refrigeración y control que lo convierten en uno de los subsistemas más críticos de todo el escáner EUV.
La apuesta de TRUMPF por este mercado va más allá de suministrar equipos desde Alemania: la compañía ha decidido abrir una fábrica en Shenzhen, China, dentro del Parque de demostración industrial chino-alemán en Baoan. Con ello, refuerza su presencia en el enorme mercado de láseres chino y deja una puerta abierta a futuras colaboraciones en ecosistemas de litografía locales.
China, la cadena de suministro de ASML y el interés por la litografía avanzada
Que un proveedor tan estratégico como TRUMPF decida instalar una planta de producción en China es una señal clara de hacia dónde mira la industria. El mercado chino de láseres industriales es gigantesco, y la perspectiva de que el país desarrolle capacidades avanzadas de litografía a medio y largo plazo resulta muy atractiva para los suministradores.
No es sólo TRUMPF: otros miembros de la cadena de suministro de ASML, como KMWE y distintos fabricantes de componentes de precisión, también han optado por levantar instalaciones en territorio chino. Todo apunta a que, paso a paso, China intenta acercarse a las tecnologías más sensibles del sector.
Aunque actualmente no pueda fabricar sistemas EUV equivalentes a los de ASML debido a limitaciones tecnológicas, de propiedad intelectual y geopolíticas, el movimiento de estas empresas alimenta la expectativa de que la litografía china dé saltos importantes en los próximos años.
Si esta tendencia continúa, no es descartable que el volumen de producción china en tecnologías litográficas avanzadas crezca de forma notable, ya sea mediante colaboración con proveedores europeos o desarrollos propios impulsados por la experiencia acumulada.
En cualquier caso, la combinación de necesidad tecnológica, tamaño de mercado y presencia de actores clave de la cadena de suministro hace pensar que la historia de la litografía EUV y de los láseres de CO2 aún tiene muchos capítulos que escribirse en Asia, con China intentando recortar distancia respecto a Europa, Estados Unidos y Taiwán.
Los sistemas EXE High-NA: el siguiente salto de ASML
Mientras perfecciona la productividad de las máquinas EUV actuales, ASML ya está desplegando su nueva generación de equipos: la plataforma EXE de alta apertura numérica (High-NA). Estos sistemas representan el próximo cambio de nivel en resolución y escalado geométrico.
Los escáneres EXE utilizan una óptica con apertura numérica (NA) de 0,55, muy superior a la de las máquinas EUV convencionales. Esto permite obtener un contraste mayor y “imprimir” características con resoluciones en torno a los 8 nm a nivel de patrón.
La plataforma High-NA está pensada para fabricación de alto volumen a partir de 2025-2026, con el objetivo de habilitar nodos lógicos de 2 nm y posteriores, así como tecnologías de memoria con densidades similares.
Al mejorar la resolución y el rendimiento del proceso, estas máquinas permiten reducir el número total de pasos de litografía y procesado necesarios para conseguir el mismo diseño de chip. Menos pasos equivalen a menos defectos potenciales, menor coste por oblea y ciclos de fabricación más cortos.
La misma fuente de luz EUV en 13,5 nm, los láseres de CO2 de potencia creciente y las ópticas extremas de Zeiss se combinan así con una arquitectura de proyección más agresiva, empujando aún más los límites físicos de lo que se puede fabricar en silicio.
Cymer y Zeiss: los otros pilares de la litografía EUV
Además de TRUMPF, otro socio vital de ASML es Cymer, empresa estadounidense especializada en fuentes de luz UV profunda y extrema. La relación entre ambas compañías es tan estrecha que ASML decidió comprar Cymer en 2013 para acelerar y asegurar el desarrollo de las tecnologías de iluminación.
Cymer aporta la “materia prima” luminosa que necesitan las máquinas de fotolitografía, desde los láseres de excímero para litografía DUV hasta los sistemas de generación de luz EUV híbridos en los que entra en juego el láser de CO2 de TRUMPF.
Por otro lado está Zeiss, que suministra los espejos y elementos ópticos de una precisión casi imposible. La luz EUV no viaja a través de lentes de vidrio tradicionales, sino que se refleja en espejos multicapa diseñados para trabajar justo en la longitud de onda de 13,5 nm.
Estos espejos deben transportar la luz desde la fuente hasta la máscara con una uniformidad extrema. Cualquier irregularidad en la reflectividad o la forma de la superficie se traduciría en distorsiones del patrón y, por tanto, en chips defectuosos.
Además de la etapa previa a la máscara, existe una óptica de proyección que traslada el patrón ya “grabado” en la luz hacia la oblea de silicio. Todo ello en un entorno de vacío alto y soportando la enorme energía asociada a la radiación EUV sin degradarse de forma prematura.
El resultado de esta colaboración entre ASML, Cymer y Zeiss es un conjunto de herramientas de fabricación tan complejas y costosas que sólo un puñado de fábricas del mundo pueden permitírselas. Pero sin ellas, los chips que dan vida a las GPU de inteligencia artificial de NVIDIA, a los SoC de Apple o a las CPU de AMD simplemente no existirían tal y como las conocemos.
Todo este ecosistema ha permitido que en la actualidad disfrutemos de circuitos integrados de 3 nm y que los primeros chips de 2 nm lleguen en torno a 2025, con la vista puesta en nodos todavía más pequeños gracias a High-NA y a la evolución de las fuentes de luz EUV.
Aunque pueda sonar exagerado, la combinación de láseres de CO2 gigantescos, plasmas de estaño más calientes que el Sol y espejos imposibles de Zeiss es la que, en última instancia, sostiene la miniaturización extrema de la electrónica moderna y el avance de todo el ecosistema digital que nos rodea.


